機械 / 半導体・自動化関連
ワイヤーボンダー/
ボールボンダー
半導体製造の分野では、各工程を総合的に捉えた高度なワンストップソリューションを提供しています。

超音波熱圧着ボールボンダー (Au、Cu、Ag)
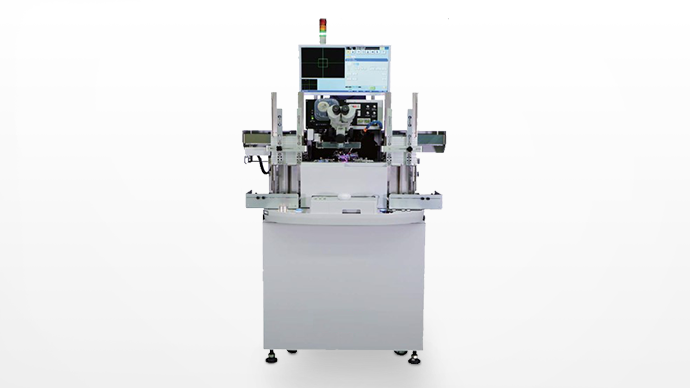
業界最速レベルのボンディングスピード
43msec/WireLED/Discrete製品の生産に最適
半導体製造の組立工程における、高速、高精度、多品種少量生産、経済性、安定性など、お客様の高度で多様なニーズにお応えします。
フルオートマチックワイヤーボンダーは、幅広い品種に対応できるよう2周波の超音波を標準搭載し、1ワイヤーあたりのボンディング時間が0.043秒という高速性能を備え、さらに進化した温度補正技術でボンディング精度3σ≦2.0μmの高い生産性を実現した装置です。
特長
- 高い生産性
- 対応フレームサイズは、最大L300mm×W90mmへ拡大
- 対応金線径12~75μm、より安定したFAB形成が可能
- 低静電容量型不着検出機能
- 64GB SSD大容量ストレージ
- USBメモリやLAN経由で生産情報を管理するトレーサビリティ機能
- SECS/GEM標準装備
- メーカ独自のホスト管理システムにも対応可能
- Windows10搭載
仕様
| ボンディング性能 | ボンディング精度 | ±2.5μm(3σ) |
|---|---|---|
| ボンディング範囲 | 56mm×80mm | |
| 生産性 | ボンディング時間 | 43msec/ワイヤー |
| 搬送システム | パッケージ・フレームサイズ |
|
| マガジン |
|
|
| その他 | 外観寸法 |
|
| 重量 | 550kg |
超音波熱圧着ボールボンダー (Au、Cu、Ag)

大型ICデバイスにも対応する
ワイドエリアボンダー
大型ICデバイスにも対応すべく縦方向のボンディングエリアを最大95mm、フレーム幅を最大105mmに拡張したモデルです。
特長
- 対応フレームサイズは、最大L300mm×W105mmへ拡大
- 対応金線径12~75μm、より安定したFAB形成が可能に
- 低静電容量型不着検出機能
- 64GB SSD大容量ストレージ
- USBメモリやLAN経由で生産情報を管理するトレーサビリティ機能
- SECS/GEM標準装備
- メーカ独自のホスト管理システムにも対応可能
- Windows10搭載
仕様
| ボンディング性能 | ボンディング精度 (セルフティーチ精度含まず) |
±3.0μm(3σ) ※対象品種により精度安定化キットが必要 |
|---|---|---|
| ボンディング範囲 | 56mm×95mm | |
| 生産性 | ボンディング時間 | 50msec/ワイヤー |
| 対応搬送システム | パッケージ・フレームサイズ |
|
| マガジン |
|
|
| その他 | 外観寸法 |
|
| 重量 | 550kg |
ウエハレベル バンプボンダー
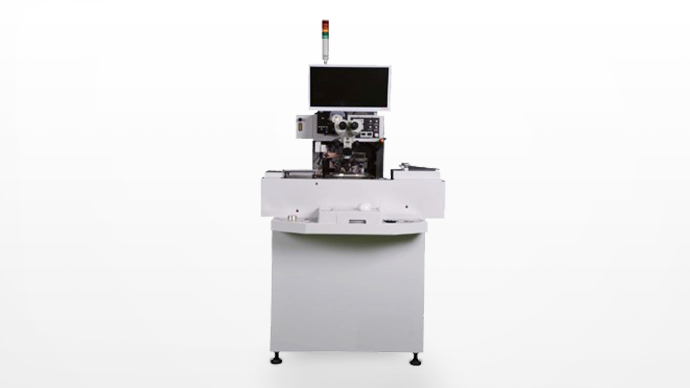
最大8インチウエハまで対応するバンプボンダー
フルオートマチックウエハレベルボンダーは、容易な品種プログラミング機能により操作性に優れた装置です。
特長
- 4~6インチウエハ (キャリア搬送)
- 4~8インチウエハ (手載せ仕様、オプションで自動搬送可能)
- 輻射熱の影響を極力抑えた小型振動子搭載
- 低温ボンディング対応
- リアルタイム位置精度補正
- ステップボンドシーケンス
- SECS/GEM標準装備
- USBメモリやLAN経由で生産情報を管理するトレーサビリティ機能
- Windows10搭載
仕様
| ボンディング性能 | ボンディング精度 | ±3.0μm(3σ) |
|---|---|---|
| ボンディング範囲 | 56mm×95mm | |
| 生産性 | ボンディング時間 | 30msec/bump (Pill-cut mode) |
| 40msec/bump (Fix-cut mode) | ||
| 対応搬送システム (キャリア搬送) |
ウエハサイズ | 最大6インチ |
| 搬送方式 | キャリアテープによる自動搬送 | |
| マガジン |
|
|
| その他 | 外観寸法 |
|
LASER用ワイヤーボンダー (回転B’g)
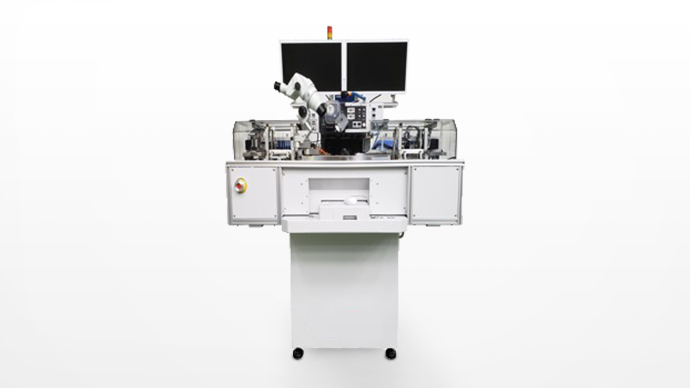
レーザー製品向けTO-Can、COC/COS搬送と回転ボンディング対応
レーザー製品向けワイヤーボンダーのCOC/COS、およびTO-Canの個片搬送方式を採用し、+90/-90度の回転ボンディングに対応しています。製品(COC/COS)はGelパックまたはWaffleパックによる供給が可能です。
特長
- +90/-90度(180角度範囲)の回転ボンディング
- 2周波超音波振動子の搭載
- 供給と収納を分けた搬送トレー設定
- 多段階の認識焦点設定
- TO-Can製品とCOC/COS製品間の製品切り替えが容易
仕様
| ボンディング性能 (セルフティーチ精度含まず) |
ボンディング精度 | ±2.5μm(3σ) (セルフティーチ精度含まず) |
|---|---|---|
| ボンディング範囲 | 15mm×80mm | |
| 生産性 | ボンディング時間 | 43msec/ワイヤー(2mm 長ワイヤー) |
| 対応搬送システム | 製品寸法 |
|
| Waffleパックサイズ | 2~4インチ | |
| Gelパックサイズ | 2~4インチ | |
| その他 | 外観寸法 |
|
| 重量 | 550kg |
ボンディングテスタ

次世代実装の研究開発から品質管理まで
半導体後工程の接合強度評価をこの1台で
金ワイヤのプル(引張)強度やボールシェア(せん断)強度を測定するため、荷重検出精度および微小な位置合わせ精度を有しています。また、ダイシェア強度やはんだ接合強度といった高荷重領域の測定も、センサー部の交換により低荷重領域での精度を保った測定が可能です。
特長
- Au、Al、Cuおよびボール、ウェッジ、リボン、ダイボンディングの評価が可能
- 測定方向、速度を3軸駆動制御により一定化することで、誰でも簡単に、同様の試験結果を入手
- 国内外の規格に準拠した試験法での数値評価
- ●JIS Z 3198-6および7
- ●MILL STD 883
- ●JEITA ED 7403 および7407
- ●IEC 749
- ●JEITA ED 4703
- ●SEMI G73-0997
測定例
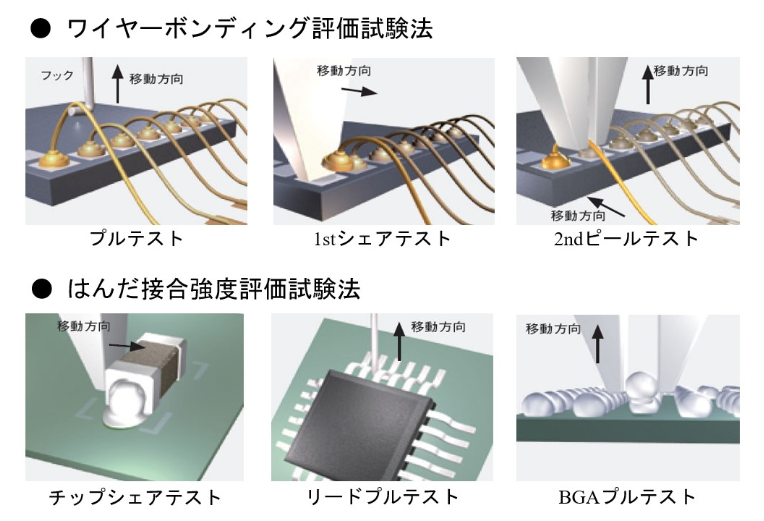
仕様
| 測定荷重範囲 | プルテスト プッシュテスト ピールテスト |
Max20kg |
|---|---|---|
| シェアテスト | Max100kg | |
| 測定精度 | ±0.2%FS | |
| 測定速度範囲 | プルテスト プッシュテスト ピールテスト |
0.001~5mm/s |
| シェアテスト | 0.001~10mm/s | |
| 駆動範囲 | X軸 | ±50mm |
| Y軸 | ±50mm | |
| Z軸 | Max70mm | |
| 観察方向 | 上下方向 | 45° |
| 左右方向 | ±90°可変 |
3Dワイヤー外観検査装置
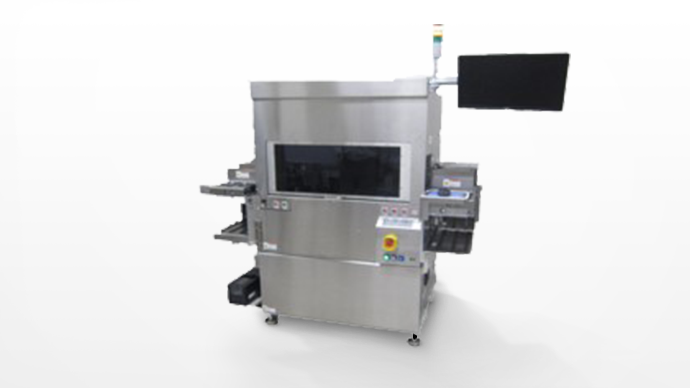
ワイヤーボンディング工程で必要とされる検査の自動化・効率化を実現する外観検査装置
特長
- 高性能3D計測
合焦点法による3D計測機能を搭載。他の3D計測手法に比べ、傾斜面や微細構造の計測に強いのが特長で、誤検知の少ない外観検査が可能です。 - 寸法計測による高信頼性検査
ワイヤー最高点高さ、ボンド幅など、約20種類の寸法計測が可能。各箇所の寸法に規格範囲を設定し、規格範囲を外れた場合に、不合格判定とすることができます。 - トレーサビリティ対応
ワークにマーキングされた2Dコードを読み取り、検査結果と共に上位サーバーへ送ることにより、トレーサビリティ環境の構築が可能。各計測結果を分析することにより、組み立てのばらつきや、傾向を把握することができ、上流工程の改善に役立てることができます。 - 簡単操作
検査を実施する品種名を選択して、検査開始を指示するだけで、簡単に検査を実施することができます。ローダー/アンローダーにより、ワークの自動供給/自動排出が可能です。
ワイヤーボンダー・ボールボンダーに関することなど、
お気軽にお問い合わせください
電子機器部



