機械 / 半導体・自動化関連
トリム&フォーミング装置・金型
半導体製造の分野では、各工程を総合的に捉えた高度なワンストップソリューションを提供しています。

トリム&フォーム装置(TF装置)

納入実績多数のリード加工装置
LD/ULD、捺印、検査などと組み合わせ、工程間を一つにつなぐことにより省力化、省人化に貢献
カスタマイズな設計で、装置間の物の移動を考慮した内容にも柔軟に対応でき、これまで多くの前後装置との組み合わせで、複合装置として納入した実績があります。
特長
得意とするカスタマイズにも柔軟に対応でき、これまで多くの前後装置との組み合わせで、複合装置として納入した実績があります
<主な複合設備>
- リードフレームローダー
- マガジン収納をはじめとするアンローダー部
- レーザー加工機をはじめとする捺印装置
- 画像認識カメラなどによる検査装置
ご希望により、さまざまなレイアウトでのカスタム設計をお受けしています
主な機構
- ローダー(スタック、スリット、トレイ、スティック、リールなど)
- アンローダー(スタック、スリット、トレイ、スティック、リールなど)
- レーザーマークなど
- 画像認識検査など
- テスト(OS、特性など)
ご希望により、さまざまなレイアウトでのカスタム設計をお受けしています
主な仕様
加工能力は標準能力6tまでのレパートリーを揃えており、お客様のニーズに柔軟にお応えします
TF金型
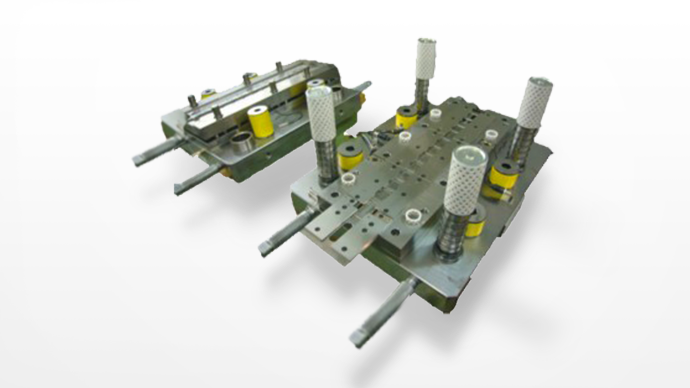
カム曲げやローラー曲げといった特殊曲げにより、パッケージへのダメージを最小限に抑えた金型構造を提案
- 抜き技術(カス上り、詰りの低減)
ダイ、パンチ、製品受けの形状をさまざまに細工可能。製品はもちろん金型破損も防止。最適な形状を提案します - 曲げ技術
製品への接触痕を最小限にして、製品外観や金型部品へのめっき付着を改善。製品の形状によりカム・ローラーなどの最適な曲げを提案します - 金型ライフ改善
刃物素材の変更や特殊コーティングにより、長寿命化に貢献
主な用途
トリム&フォーム金型は、半導体生産の最終段階で用いられます。パッケージを個別に切り出し、リード成形する工程で使用されます。
- レジンカット
パッケージ外側、タイバー、リードで囲まれた部分のバリ(樹脂)を打ち抜く - タイバーカット
タイバーを打ち抜く - リードカット
リード先端を切断し、パッケージを個片にする - リードフォーミング
リード先端を曲げて形を整える
導入事例
- SOP系製品
- DIP系製品
- SOT系製品
- SON系製品
レーザー加工装置(マーキング、バリ取り、樹脂除去)
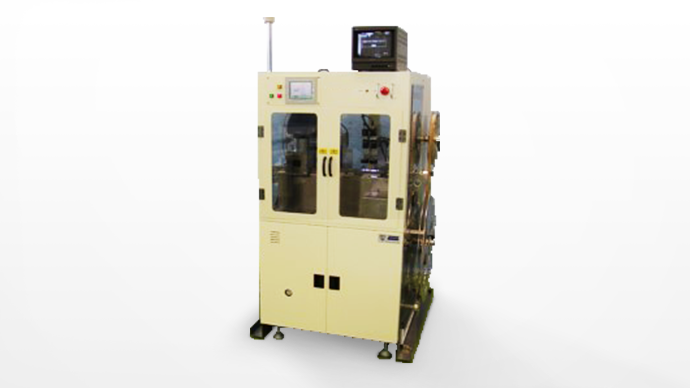
レーザー照射で半導体製品の不良発生率を低下
各半導体素子製品への捺印を目的とした装置です。フレームごとでの素子およびフレーム上への印字、個片化された素子への印字、2次元コード印字などが可能です。
また、レーザー照射による樹脂部のバリ取り、除去対応も可能です。樹脂の除去は従来、金型を用いて行われてきた工程ですが、レーザー照射装置を用いることにより、半導体製品の不良発生率を下げるだけでなく、金型のメンテナンス(ダイ、パンチの損耗にともなう交換作業など)から開放されます。
主な用途
パッケージ表面に製品名、製造メーカー、ロット番号などを捺印する工程で使用されます。主に半導体製品が個片化され、リード成形された後に使用されます。
装置構成例
- フレーム供給部
- 方向・品種確認部(オプション)
- レーザーマーク部
- 外観検査部(オプション)
- ブラシ部(オプション)
- フレーム収納部
トリム・フォーミング装置・金型に関することなど、
お気軽にお問い合わせください
電子機器部



