機械 / 半導体・自動化関連
半導体・電子部品用検査装置
半導体製造の分野では、各工程を総合的に捉えた高度なワンストップソリューションを提供しています。

ボンディングテスタ

次世代実装の研究開発から品質管理まで
半導体後工程の接合強度評価をこの1台で
金ワイヤのプル(引張)強度やボールシェア(せん断)強度を測定するため、荷重検出精度および微小な位置合わせ精度を有しています。また、ダイシェア強度やはんだ接合強度といった高荷重領域の測定も、センサー部の交換により低荷重領域での精度を保った測定が可能です。
特長
- Au、Al、Cuおよびボール、ウェッジ、リボン、ダイボンディングの評価が可能
- 測定方向、速度を3軸駆動制御により一定化することで、誰でも簡単に、同様の試験結果を入手
- 国内外の規格に準拠した試験法での数値評価
- ●JIS Z 3198-6および7
- ●MILL STD 883
- ●JEITA ED 7403 および7407
- ●IEC 749
- ●JEITA ED 4703
- ●SEMI G73-0997
測定例
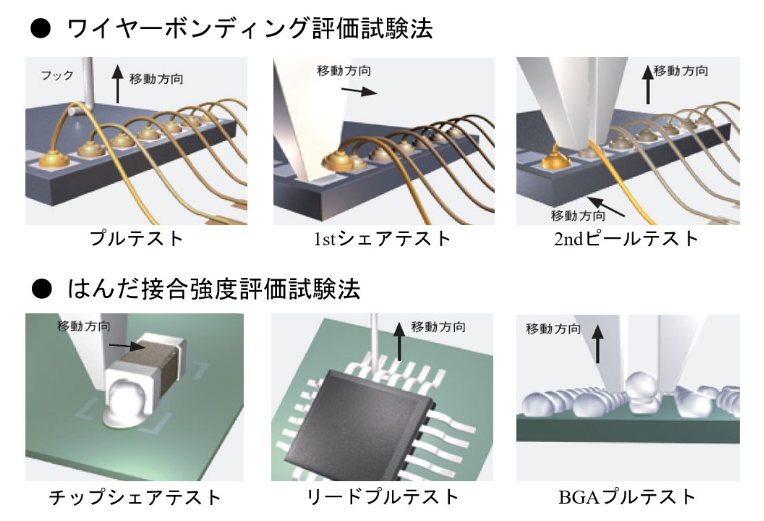
仕様
| 測定荷重範囲 | プルテスト プッシュテスト ピールテスト |
Max20kg |
|---|---|---|
| シェアテスト | Max100kg | |
| 測定精度 | ±0.2%FS | |
| 測定速度範囲 | プルテスト プッシュテスト ピールテスト |
0.001~5mm/s |
| シェアテスト | 0.001~10mm/s | |
| 駆動範囲 | X軸 | ±50mm |
| Y軸 | ±50mm | |
| Z軸 | Max70mm | |
| 観察方向 | 上下方向 | 45° |
| 左右方向 | ±90°可変 |
ソルダチェッカー
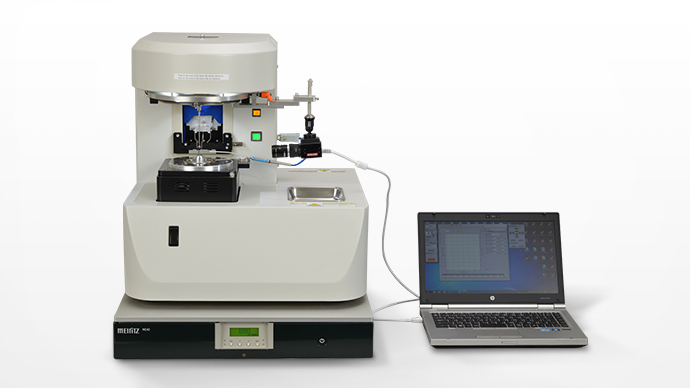
電子部品とはんだとのぬれ性を時間軸で計測
高密度実装における電子部品の小型化が急速に進展していますが、本装置は最新の微小電子部品でも測定が可能です。はんだぬれ性試験(ウェッティングバランス法)は、はんだぬれ性を定量的に評価するための試験方法として国内外の規格にもなっています。最も基本的な評価法であるはんだ槽平衡法から表面実装部品を評価するはんだ小球平衡法、ソルダペーストを用いて表面実装部品を評価する急加熱昇温法やプロファイル昇温法まで、1台でさまざまな試験が可能です。
特長
- 0603、0402といった微小チップ部品の高精度評価が可能
- 各種部品に対応したチャックを用意しており、さまざまな形状の部品の評価が可能
- 温度プロファイル法では16ゾーンの温度設定により、細かな加熱挙動が設定可能
- ハロゲンフリー低温ハンダペーストの挙動解析、N2ガスパージも対応可能
- ぬれ状況を高速カメラ(430FPS)またはアライメントカメラで観察可能
- X-Yステージをモータ駆動とすることで、精密な位置合わせが可能(LEDライト付)
- 用途に合わせて標準タイプ、高感度タイプ、廉価版の3機種をラインアップ
- あらゆる液剤での評価が可能
- 粉体対液剤の評価が可能
仕様
| 測定レンジ | ±10mN、50mN | |
|---|---|---|
| 温度設定範囲 | 常温~450℃ | |
| 温度精度 | ±2℃(245℃設定時) | |
| はんだポット | φ60mm、深さ30mm(深さ60mm使用可) | |
| 浸せき時間 | 1~999s、1~999min | |
| 浸せき深さ | 0.01~1mm | 0.01step |
| 1~20mm | 0.1step | |
| 浸せき速度 | 0.1~1mm/s | 0.1step |
| 1~5mm/s | 0.5step | |
| 5~30mm/s | 5step | |
| 応力精度 | ±0.1%FS(10mN設定時:0.01mN、50mN設定時:0.05mN) | |
| 時間軸応答性 | 0.14s (ゼロ-フルスケール) | |
| ステージ移動距離 | X軸:±5mm、Y軸:±5mm | |
| サンプル重量 | 10g | |
| 電源 | AC100-220V±10% 50/60Hz | |
| 消費電力 | 600W | |
| 重量 | 45kg | |
| 寸法 |
|
|
| オプション | はんだ小球平衡法キット、急加熱昇温法ユニット、 プロファイル昇温法ユニット、アライメントカメラユニット、 高速ぬれ画像解析システム |
|
| 動的ぬれ性試験キット、アクリル風防、N2チャンバ、 アクティブ微小振動制御システム |
||
スクラッチ試験機

μm以下の薄膜の密着強度を定量的に測定
材料表面に形成された薄膜と基材の密着強度を評価するスクラッチ法を進化させ、より薄い膜の剥離検出を実現したマイクロスクラッチ法(JIS R-3255およびJIS K7376準拠)により膜厚がμm以下の超薄膜の密着強度評価が可能な試験機です。この薄膜の破壊検出に特化したマイクロスクラッチ法に加え、メーカー独自の特許技術(特許5070146号)による高感度破壊検出機構を備え、超薄膜の付着強度を評価します。
特長
- 膜厚μm以下の超薄膜の密着強度評価が可能
※膜厚10nmの測定実績有 - サンプルを加熱しての加熱環境下での評価が可能
- レンズなどの曲面測定が可能
- 時系列摩擦力ヒストグラム(TSFH)解析により100×100μmの領域の摩擦係数評価が可能
用途
- DLC
- 光学薄膜
- 金属膜
- PETフィルム
- 機能性薄膜(AR、RF)
- 電極膜など
仕様
| 荷重検出機構 | 荷重印加範囲 | 1~1,500mN |
|---|---|---|
| 荷重分解能 | 0.3mN | |
| 許容過負荷 | 300%FS | |
| 水平方向信号出力 | 検出信号 | 速度信号 |
| 周波数レンジ | 20Hz~10kHz | |
| 励振周波数 | 45Hz | |
| 励振振幅 | 0、5、10、20、40、50、80、100μm | |
| 垂直方向信号出力 | 検出信号 | 加速度信号 ※特許技術 |
| 周波数レンジ | 20Hz~10kHz | |
| 触針 | 材質と形状 | ダイヤモンド(R5、10、15、25、50、100μm) |
| サファイア(R250、500μm) | ||
| φ3/32インチボール取付可 | ||
| Z軸駆動機構 | 駆動方式 | ステッピングモータ駆動 |
| 荷重印加方向 | 駆動範囲 | 20mm(手動にて+30mmの粗動範囲有) |
| 駆動分解能数 | 0.5μm | |
| 駆動速度(測定時) | 0.1~10μm/s | |
| 駆動速度(準備時) | 1mm/s | |
| X軸駆動機構 | 駆動方式 | ステッピングモータ駆動 |
| スクラッチ方向 | 駆動範囲 | 20mm |
| 駆動分解能数 | 0.5μm | |
| 駆動速度(測定時) | 0~20μm/s | |
| 駆動速度(準備時) | 1mm/s | |
| 試料台XY軸駆動機構 | 駆動方式 | マイクロメータによる手動駆動 |
| 駆動範囲 | ±6.5mm | |
| データ出力方式 | USB | |
| 寸法および重量 |
|
|
| 電源 | AC100~240V |
高加速寿命試験装置 HAST装置


半導体、電子部品、材料系の高加速寿命評価に
半導体、電子部品業界では、小型化や高密度化が急速に進んでいる中、信頼性向上もますます重要になっており、それを評価する時間も大きなテーマになっています。当社が取り扱っている装置は2槽式構造による広い寸法によりこれらのニーズに応えます。
特長
- スライドトレイ方式により高い作業性を実現
- 試験槽と蒸気発生槽がそれぞれ独立した2槽式構造により、広い有効寸法と、幅広い使用湿度範囲を実現
- 2つの制御方式に対応(不飽和制御、飽和制御)
- 3つの排気モードに対応(湿度維持徐冷モード、保湿冷却モード、急速排気モード)
- 扉の内面には接続作業が簡単にできる電圧印加端子を装備
- チャンバー表面には汚れ付着防止と洗浄性に優れた電解研磨処理
マイクロフォーカスX線検査装置

にじみのない鮮明画像で内部欠陥を高精度に検査
半導体業界の進歩による微少化、高密度化、さらにはBGA、CSPといった接合方法に対し非破壊で検査、解析します。 独自のマイクロフォーカスX線発生装置と高性能X線ディテクターを組み合わせることで、高解像度、高拡大のX線透視画像を実現。作業性向上のためスキャニングから透視画像のすべてをパソコンにて制御し、お客様のサンプルに合わせた特注機の提案も可能です。
全自動静電破壊装置
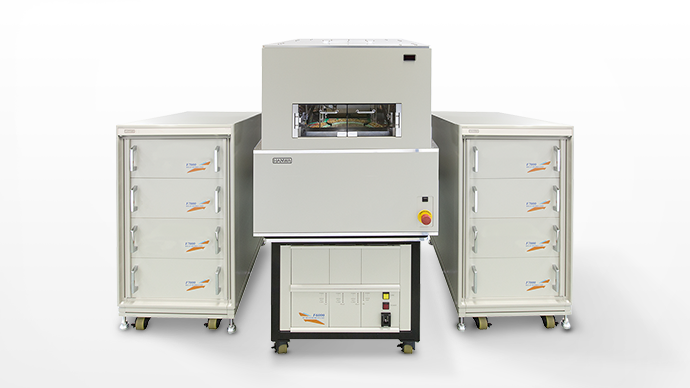
コンデンサ放電によるHBM、MMに対応した試験装置
1000ピンを超える多ピン半導体に対するESD試験に有効
国際規格に準拠したテスト(JEDEC、ESDA、AEC、およびJEITA)が可能です。このシステムのユニークな短絡放電回路は、独自の機械設計によって可能になりました。 短絡は、データに対するインダクタンスおよびキャパシタンスの影響を最小にします。さらに、単一の回路を使用することにより、テストされる各デバイスピンのデータの安定性が保証されます。
コンパクトESD試験器

コンデンサ放電によるHBM、MMに対応した試験装置
2~3ピンの少ピンの半導体へのESD試験に有効
試験操作が簡単で、持ち運び可能な静電破壊試験器です。リーク測定機能も備えており、ESDによる破壊判定を本装置のみで行うことができます。
プロービングハンドラー
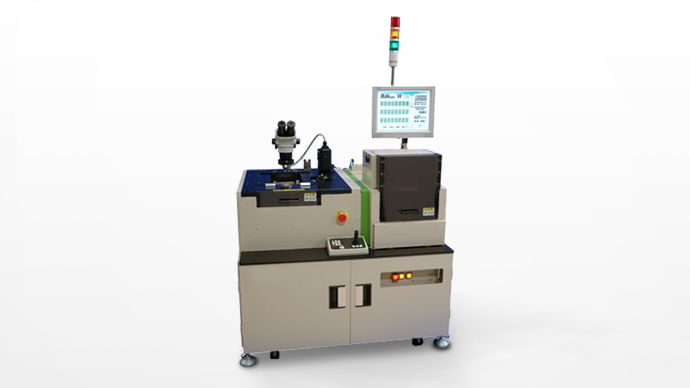
ダイシング済みのWLCSPやパッケージ基板をプロービング方式で検査
ダイシングされたWLCSPやパッケージ基板(BGA、QFNなど)のハンドラー装置での検査を独自のコンセプトであるプロービング方式で実現。独自のXY位置補正機能とプロファイリング機能を採用することで、ダイシング後のフィルム張力やダイサー、ブレードによる「歪み」や「たわみ」の位置ずれを補正し、多数個同測に対応したプロービングを実現します。
特長
- ダイシングされたWLCSPやパッケージ基板(BGA、QFNなど)に対応
- ダイシング後の位置ずれを補正し、多数個同測に対応したプロービングを実現
- フィルムフレームへのチップ再貼付での検査にも対応
- 1チップ内の複数ポイントでプロービングが可能
- フィルムのダレの影響を受けないリングクランプ方式を採用
- 小径VAC穴により1mm以下の小チップサイズにも対応
- チャック表面のサンドブラスト処理とエアー吹き出し機構にてチャックからのフィルムの剥離性を向上
- 低ノイズ:チャック上 -80db以上(参考値: 30KHz~30MHz ループANT実測値)
- 極小径VAC穴により0.5mm以下の小チップサイズにも対応(オプション)
- 50~150℃までの高温領域や、25℃±0.3℃の高精度な温度コントロール機能に対応(オプション)
- 磁気デバイスに対応可能な非磁性仕様
※参考値(標準機):チャック上 0.04mT 搬送経路上 0.2mT
半導体・電子部品用検査装置に関することなど、
お気軽にお問い合わせください
電子機器部



