機械 / 半導体・自動化関連
ダイボンダー
半導体製造の分野では、各工程を総合的に捉えた高度なワンストップソリューションを提供しています。
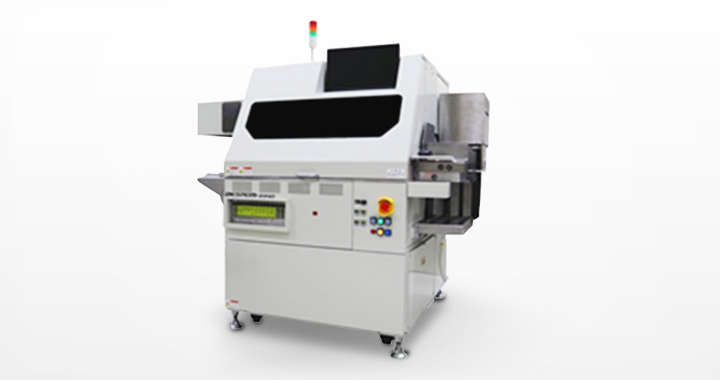
ソフトソルダー用ダイボンダー(8インチ)
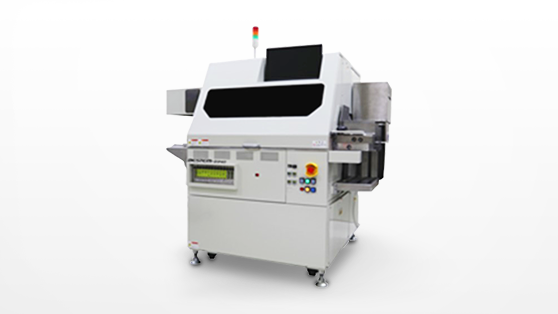
高い接合品質を要求されるパワーデバイス対応のはんだ接合プロセス用ダイボンダー
特長
- 高性能還元フィーダーによるはんだ溶融接合プロセスに対応
- はんだ成型(スパンカー)機能採用による高い接合品質
- 幅100mmまでの大判フレームに対応
- ウエハマッピングや各種トレサビリティにも柔軟に対応
- 最大φ8インチまでのウエハサイズに対応
仕様
| 接合方式 | ワイヤはんだ供給接合 |
|---|---|
| ボンディングスピードUPH | 6,000(SOP8連マトリックスフレーム、チップサイズ□3mm相当条件) |
| ボンディング精度 (Cuアイランド、スパンカー& 角錐コレット使用条件) |
XY:±38µm(3σ) |
| Θ:±1°(3σ) | |
| チップサイズ | □1~□11mm *オプション:15mm |
| リードフレームサイズ |
|
| マガジンサイズ |
|
| ウエハサイズ | 最大φ8インチ |
| 装置サイズ |
|
| 重量 | 約1,600kg |
ソフトソルダー用ダイボンダー(12インチ)
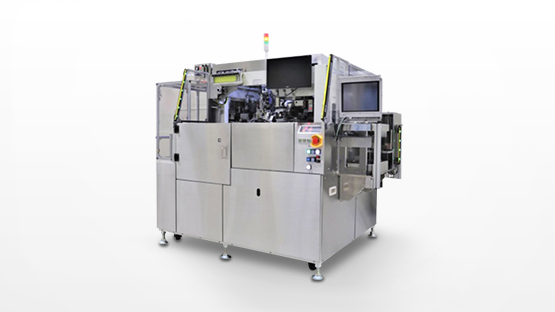
高い接合品質を要求されるパワーデバイス対応のはんだ接合プロセス用ダイボンダー
特長
- 高性能還元フィーダーによるはんだ溶融接合プロセスに対応
- はんだ成型(スパンカー)機能採用による高い接合品質
- 幅100mmまでの大判フレームに対応
- ウエハマッピングや各種トレサビリティにも柔軟に対応
- 最大φ12インチまでのウエハサイズに対応
仕様
| 接合方式 | ワイヤはんだ供給接合 |
|---|---|
| ボンディングスピードUPH | 6,000(SOP8連マトリックスフレーム、チップサイズ□3mm相当条件) |
| ボンディング精度 (Cuアイランド、スパンカー& 角錐コレット使用条件) |
XY:±38µm(3σ) |
| Θ:±1°(3σ) | |
| チップサイズ | □1~□11mm *オプション:□15mm |
| リードフレームサイズ |
|
| マガジンサイズ |
|
| ウエハサイズ | 最大φ12インチ |
| 装置サイズ |
|
| 重量 | 約2,000 kg |
エポキシ用ダイボンダー

12インチウエハ対応のIC・LSI向けの高速・高精度ダイボンダー
ツインディスペンサーを搭載し、高いUPHを誇ります。
独自のピックアップシステム採用により最薄15umまでピックアップが可能。
特長
- 高スループット、小フットプリント、品種切替時間短縮でTCO削減
- 調整容易化、リワーク機能搭載で優れた操作性を実現
- マウント・プリフォーム間の最小化、経時変化を防止し、無駄な動きを短縮
- 新開発ツインディスペンスシステム搭載で多様なペーストに対応
- ニードルレスピックアップシステム(オプション)でダメージレスピックアップを実現
仕様
| 接合方式 | エポキシ接合/熱圧着(オプション) |
|---|---|
| ボンディングスピード | 0.18sec/cycle |
| ボンディング精度 | XY:±25μm、3σ |
| θ:1°、3σ(□1.0mm以上) | |
| θ:3°、3σ(□1.0mm未満) | |
| チップサイズ | □0.3~□8.0mm t=0.075~0.5mm オプション:□0.15~2.0mm(認識レンズ変更) |
| リードフレームサイズ |
|
| マガジンサイズ |
|
| ウエハサイズ | 最大φ12インチ |
| 用力 | 電源:AC200V 30A ドライエア:0.4MPa(60L/min) 真空源:-66.7KPa(100L/min) |
| 装置サイズ |
|
| 重量 | 約1,600 kg |
| オプション機能 |
|
ダイソーター
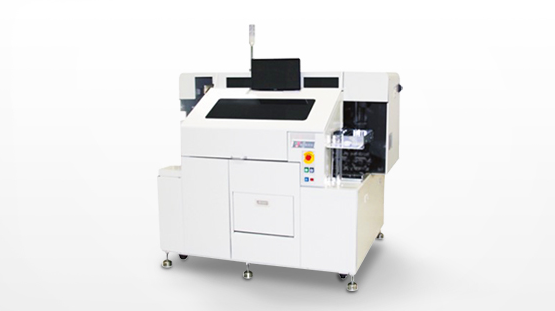
ダイシングされたウエハより良品ダイのみをピックアップし、トレイに整列・収納
MEMSからIGBT、CMOSセンサーまで対応実績豊富
特長
- 高精度ソーティング XY:±38μm(3σ)
- チェンジキットにより6、8、12インチウエハに対応
- 独自のニードルレスピックアップ技術(オプション)による薄厚ダイ対応
仕様
| ウエハサイズ | □6、8、12インチ |
|---|---|
| チップサイズ | □1.5~25mm |
| 搬送可能トレイサイズ | □2、3、4インチ |
| 配列精度 | XY:±38µm(3σ) |
| 装置サイズ |
|
| 重量 | 約1,600 kg |
ボンディングテスタ

次世代実装の研究開発から品質管理まで
半導体後工程の接合強度評価をこの1台で
金ワイヤのプル(引張)強度やボールシェア(せん断)強度を測定するため、荷重検出精度および微小な位置合わせ精度を有しています。また、ダイシェア強度やはんだ接合強度といった高荷重領域の測定も、センサー部の交換により低荷重領域での精度を保った測定が可能です。
特長
- Au、Al、Cuおよびボール、ウェッジ、リボン、ダイボンディングの評価が可能
- 測定方向、速度を3軸駆動制御により一定化することで、誰でも簡単に、同様の試験結果の入手が可能
- 国内外の規格に準拠した試験法での数値評価
- ●JIS Z 3198-6および7
- ●MILL STD 883
- ●JEITA ED 7403 および7407
- ●IEC 749
- ●JEITA ED 4703
- ●SEMI G73-0997
測定例
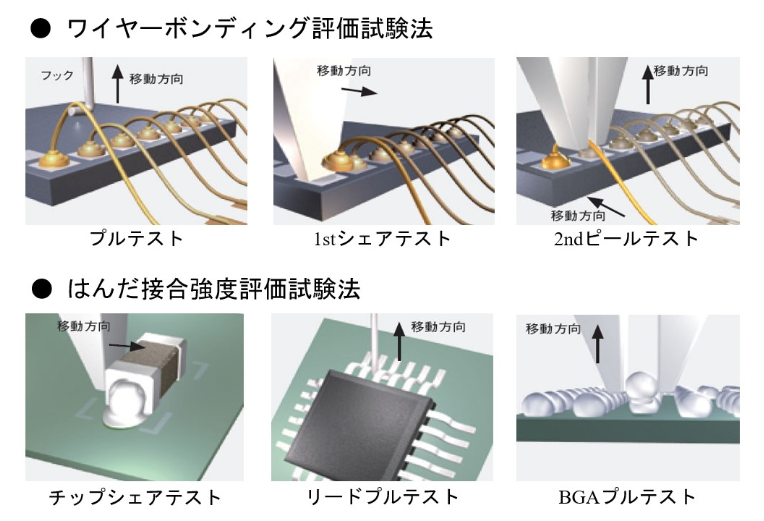
仕様
| 測定荷重範囲 | プルテスト プッシュテスト ピールテスト |
Max20kg |
|---|---|---|
| シェアテスト | Max100kg | |
| 測定精度 | ±0.2%FS | |
| 測定速度範囲 | プルテスト プッシュテスト ピールテスト |
0.001~5mm/s |
| シェアテスト | 0.001~10mm/s | |
| 駆動範囲 | X軸 | ±50mm |
| Y軸 | ±50mm | |
| Z軸 | Max70mm | |
| 観察方向 | 上下方向 | 45° |
| 左右方向 | ±90°可変 |
ダイボンダーに関することなど、
お気軽にお問い合わせください
電子機器部



